器材功用有直接的影响。研讨清楚各类缺点的构成和成长机制很重要。本文带你了解
在SiC晶体中存在各种缺点,其间一些会影响器材的特性。SiC缺点的首要类型包含微管、晶界、多型夹杂物、碳夹杂物等大型缺点、以及堆垛层错(SF)、以及刃位错(TED)、螺旋位错(TSD)、基面位错(BPD)和这些复合体的混合位错。就密度而言,最近质量相对较好的SiC晶体中,微管是1〜10个/cm²,位错的密度约为10³~10⁴长达个/cm²。至今,与Si比较,SiC的缺点密度依然较大。
微管被以为是位移非常大的螺旋位错,中心存在空泛。此外,碳夹杂物是在块状晶体成长过程中嵌入的碳尘异物,是高密度位错的来历。这些对器材来说是丧命的缺点。
图1显现了通过熔融KOH对8°偏角(0001)4H-SiC衬底的标明上进行蚀刻,在晶体缺点部分构成凹坑的显微镜相片。位错线在垂直于外表的方向上延伸,反映了晶体的对称性,蚀刻后呈现六角形的凹坑。另一方面,基面位错在(0001)面(与外表平行的方向),位错线朝不同方向延伸,构成的凹坑呈椭圆形。在螺旋位错中存在多个晶体偏移巨细不同的位错。晶体偏移较大的螺旋位错和混合位错会在器材中发生漏电流。关于小型位错,大多数不会影响器材功用。
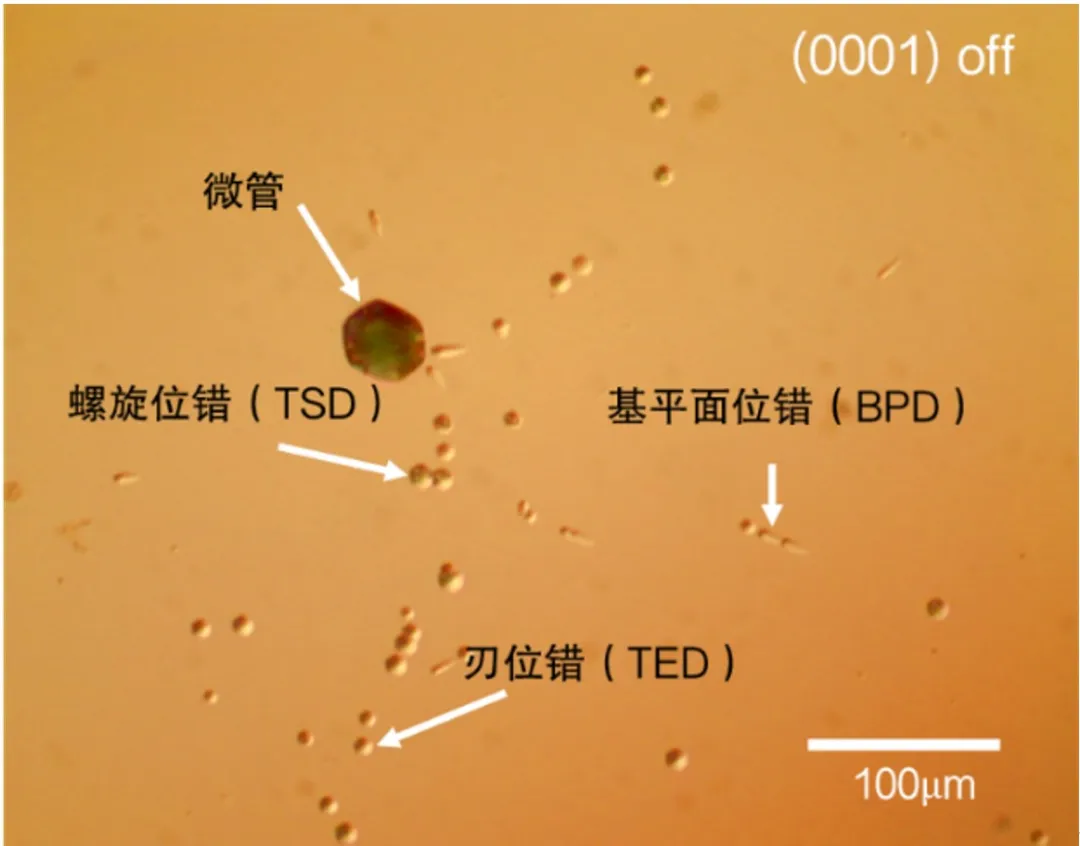
仔细观察基面位错的结构,不难发现它具有被两个部分位错(Shockley部分位错)围住的线性结构。关于基面位错,当双极性电流流过SiC器材时,被两个部分位错围住的区域会发生堆垛层错扩展,这是导致电阻增加等器材特性劣化的原因。
(3)被抓获的电子和空穴复兼并开释能量。开释的能量导致部分位错移动,移动的部分构成堆垛层错,堆垛层错区域进一步抓获电子和空穴,导致部分位错的持续移动(堆垛层错区域扩展)。构成堆垛层错的区域起到高电阻区域的效果。
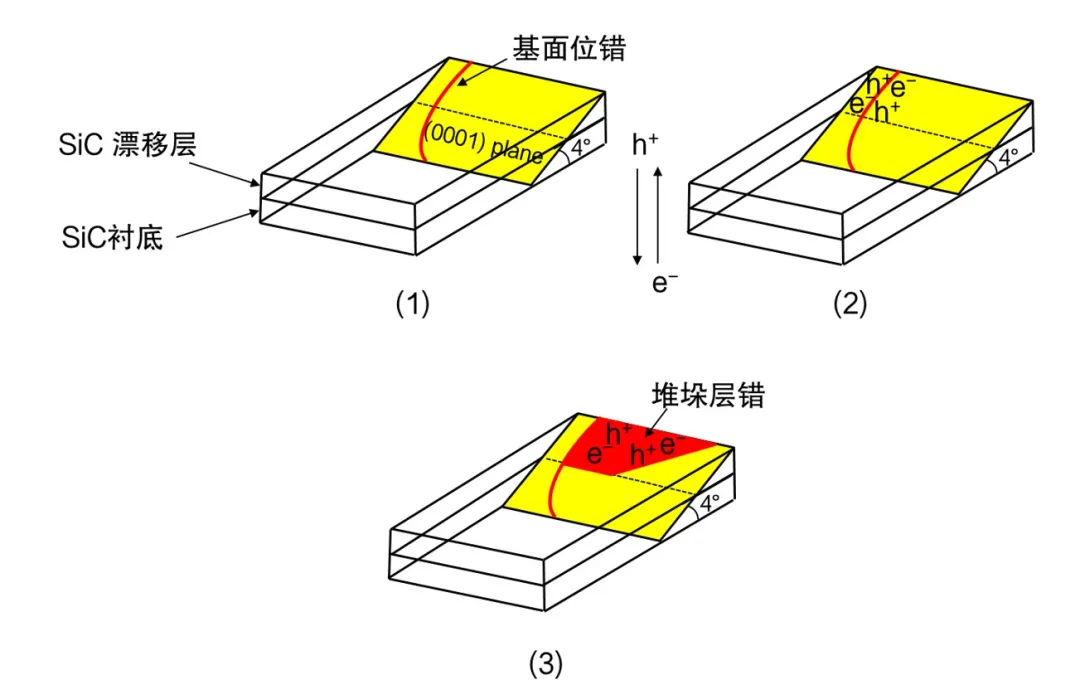
在高浓度n型区域,因为电子和空穴的复合寿数较短,缓冲层或衬底的空穴密度较低。因而,堆垛层错的扩展发生在漂移层中。此外,堆垛层错具有晶体学上安稳的(不移动的)鸿沟。因而,扩展的堆垛层错区域多呈现出典型性的矩形或三角形。
通过恰当设置外延成长条件,可大起伏削减漂移层中的基面位错。现在的SiC外延能够终究靠采取了恰当的缓冲层,显着下降漂移层中基面位错的密度。
在对SiC进行离子注入时,会发生晶体缺点。图3、图4展现了对SiC进行高浓度Al离子注入后再退火的横截面TEM(透射电子显微镜)图画。从图3中能够精确的看出,注入Al的区域存在着高密度因变形而看起来黑色的缺点。即便通过高温退火,晶体仍未彻底康复。在图4中,扩大了缺点部分,展现了高分辨率TEM图画(晶格图画)。能够观察到每4层构成一个周期(周期为1纳米)的结构,标明这是4H-SiC。图中箭头所指方位插入了一层剩余的层,构成了Frank堆垛层错。关于这一部分,已知注入的元素Al等以层状办法集合,构成堆垛层错。
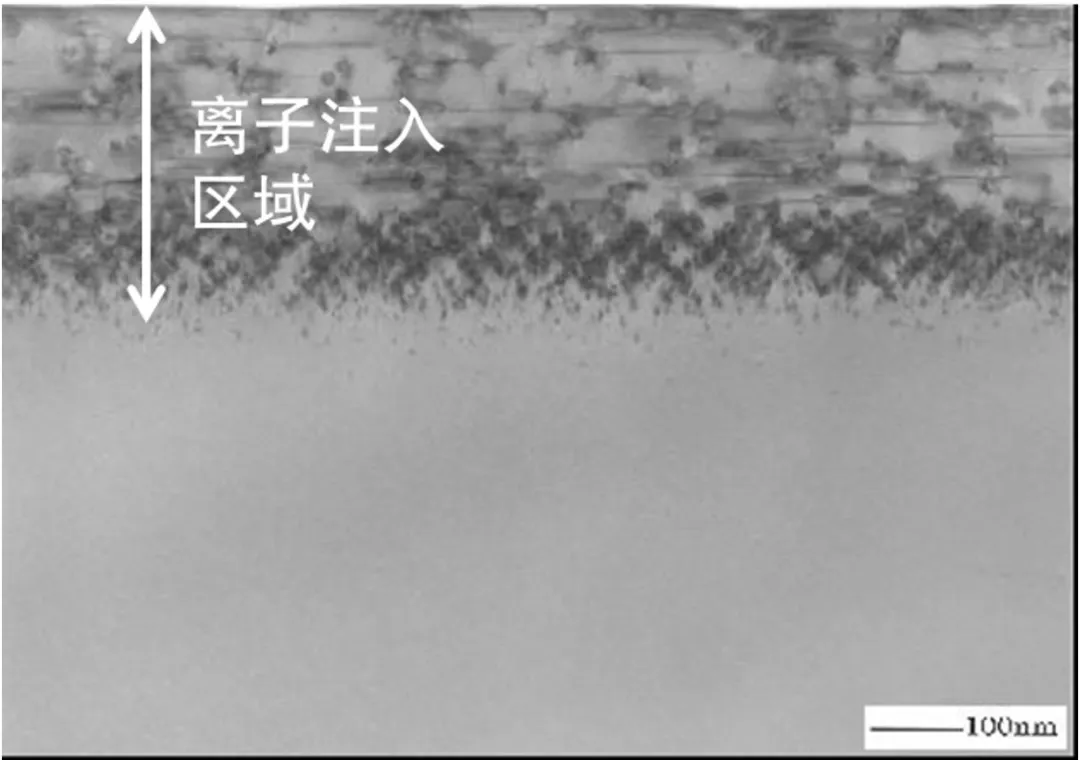

离子注入发生的缺点被以为会作为载流子的复合中心。例如,在SiC的PN二极管中,会削减存储电荷并下降反向康复电流。最近,也有测验将离子注入发生的缺点用作按捺SiC MOSFET体二极管特性劣化的办法。
高速开关封装SiC MOSFET:TO-247-4L【SCT3xxx xR系列】
意法半导体推出功用丰厚的电气阻隔栅极驱动器,为碳化硅或硅功率晶体管供给更好操控和维护
罗姆第4代SiC MOSFET裸芯片批量应用于吉祥集团电动汽车品牌“极氪”3种主力车型